隱形雷射晶圓分割(stealth dicing)技術為一種將雷射激光聚焦於矽晶圓內部,在其內部形成變質層,通過擴展膠膜等方法,將晶圓分割成晶片(die)的分割方法,目前針對使用隱形雷射於變質層中產生裂縫後,探討施力於晶圓使其分割成各自單一晶片之破裂機制的文獻仍十分有限,且僅止於進行大量實驗以獲得破裂趨勢資訊階段,尚無一有效模型可以分析應用隱形雷射技術於矽晶圓中產生裂縫後,晶圓受力分割之破裂機制。本實驗室團隊與日月光半導體製造股份有限公司進行產學合作,探討隱形雷射技術應用於晶圓分割之破裂機制,建立一有效模型分析應用隱形雷射技術於矽晶圓中產生裂縫後,晶圓受力分割之破裂機制。此有效模型已提供日月光公司使用,以期迅速獲得在不同機台參數下,應用隱形雷射的晶圓之破裂趨勢,以利提高生產線上晶圓分割之良率。
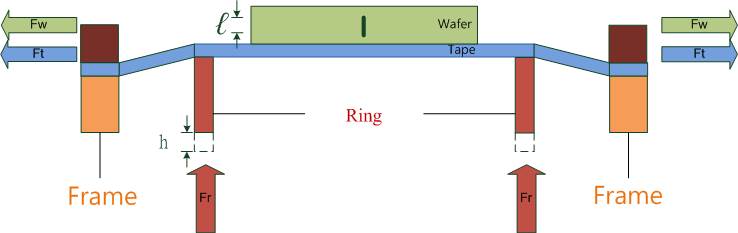
Physical model of silicon wafer induced by tape expansion
(a)
 (b)
(b)  (c)
(c) 
Fracture model(videos): (a) fractured unsuccessfully ; (b) partial fractured; (c) fractured successfully.
